
UPC CC-5 金属表面保护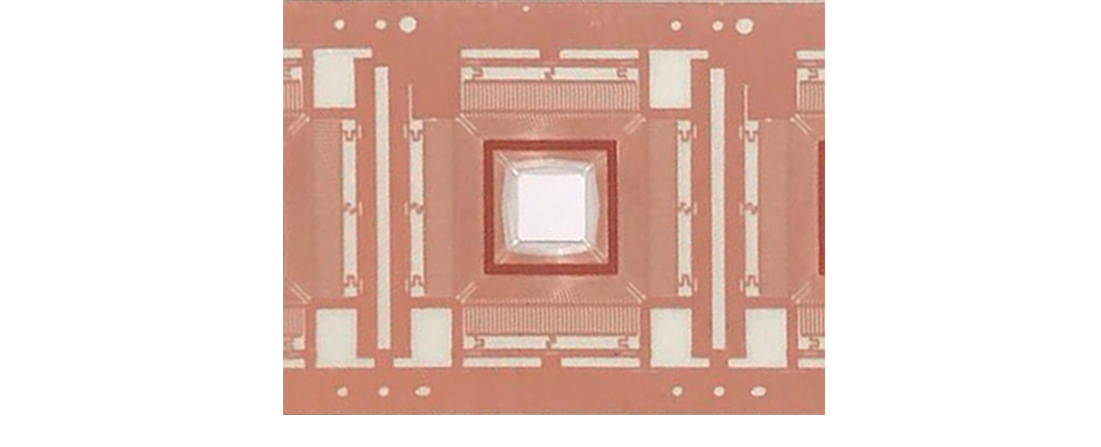 UPC CC-5金属表面保护适用于IC Leadframe、SMD_LED和直插LED的产品上,有效防变色及防氧化后处理工艺,适用于银、铜、镍、金、锡的镀层上使用。它能特别增强银镀层表面防腐及抗硫化能力的特性。经UPC CC-5保护处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
UPC CC-5金属表面保护适用于IC Leadframe、SMD_LED和直插LED的产品上,有效防变色及防氧化后处理工艺,适用于银、铜、镍、金、锡的镀层上使用。它能特别增强银镀层表面防腐及抗硫化能力的特性。经UPC CC-5保护处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
特性与优点
1. 有效防止各种型号(导电胶,非导电胶)银胶扩散产生的问题,不影响镀层特性。
2. 具有封孔的能力,同时防止氧化及防变色(银、金、铜、镍、锡表面的保护)。
3. 不影响打线(Wire-bonding),上芯片(DA,Die-Attachment),注塑(Molding)。
4. 不含任何有害物质的成分,符合RoHS标准。
5. 比较传统的保护水更有效提升抗硫化能力。
6. 经UPC CC-5保护处理后表面有疏水效果,有效防止水印及水渍残留。
7. 药水不含沉淀物,性质稳定,操作简易。
UPC PP01 剥离剂
UPC PP01剥离剂研发应用在半导体引线框架生产中使用为除去漏镀或侧漏的流程上,使用在各种铜、铜合金材料、铁料、铁镍合金材料(A42)上把漏银脱净,而且不会脱伤底材和功能性镀银的表面。它能用于卷料高速喷镀(Reel to Reel Jet silver plating),卷料重复压板式电镀(Step and Repeat mold-press Reel to Reel Silver Plating)和片料式重复压板式电镀(Strip/Strip mold-press type)的生产线。
特性与优点
1. 有效把制程所产生的漏镀(正面或背面),侧漏(引线框框架中)不必要的银脱净。
2. 不脱伤底材。
3. 使用时间长、持久寿命,具备良好的稳定性。
4. 不含氰化物。
5. 广阔的生产控制参数(例如:浓度、温度等)。
UPC IC引线框架表面保护 CP10X IC引线框架表面保护CP10X有效防变色及防氧化的功能,可应用在IC Leadframe的铜合金材料、线路板上。比传统的铜保护更有效耐高温及防变色的后处理工艺,经IC引线框架表面保护CP10X处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
IC引线框架表面保护CP10X有效防变色及防氧化的功能,可应用在IC Leadframe的铜合金材料、线路板上。比传统的铜保护更有效耐高温及防变色的后处理工艺,经IC引线框架表面保护CP10X处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
特性与优点
1. 有效防止高温烤焗时所产生铜变色及氧化发紫发黑,不影响镀层特性。
2. 不影响打线(Wire-bonding),上芯片(DA,Die-Attachment),注塑(Molding)。
3. 具有良好的可焊性,在大功率的铜引线架上,例如TO 126、大功率产品、铜排,具有良好沾锡抗散特性。
4. 药水稳定,操作简易。
5. 不含任何有害物质的成分,符合RoHS标准。
UPC IC引线框架表面保护 CP66X![]() IC引线框架表面保护CP66X有效防变色及防氧化的功能,可应用于IC Leadframe的铜合金材料、线路板上。比传统的铜保护更有效耐高温及防变色的后处理工艺,经IC引线框架表面保护CP66X处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
IC引线框架表面保护CP66X有效防变色及防氧化的功能,可应用于IC Leadframe的铜合金材料、线路板上。比传统的铜保护更有效耐高温及防变色的后处理工艺,经IC引线框架表面保护CP66X处理后亦不会影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
特性与优点
1. 有效防止高温烤焗时所产生铜变色及氧化发紫发黑,不影响镀层特性。
2. 不会影响打线(Wire-bonding),上芯片(DA,Die-Attachment),注塑(Molding)。
3. 可焊性良好,在大功率的铜引线架上,例如TO 126、大功率产品、铜排,具有良好沾锡抗散特性,取代日本进口防铜氧化工艺。
4. 药水稳定,操作简易。
5. 不含任何有害物质的成分,符合RoHS标准。
UPC IC引线框架表面保护5号
IC引线框架表面保护5号是铜保护后处理电子化学品,防止IC Leadframe在高温烤焗时而产生剥离的后处理工艺,经表面保护5号处理后,不影响镀层表面功能性的特性(例如:打线、固晶上芯片、注塑等)。
特性和优点
1. 有效防止高温烤焗时所产生铜剥离的问题,不影响镀层特性。
2. 药水稳定, 操作简易。
3. 提高铜引线框架功能的可靠性。
UPC IC Leadframe防银胶扩散 EBO inhibitor #1
UPC EBO inhibitor #1能有效防止各种银胶扩散(导电胶,非导电胶)在引线框架的后处理制程工艺,经UPC EBO inhibitor #1处理后,亦不会影响引线框架表面功能性的特性(例如:打线、固晶上芯片、注塑等)。适用于高速卷镀,重复压板式卷镀和片料压板式IC引线框架电镀的制程上。
特性与优点
1. 有效防止各种型号(导电胶,非导电胶)银胶扩散产生的问题,不影响镀层特性。
2. 不影响打线(Wirebonding),上芯片(DA,Die-Attachment),注塑(Molding)。
3. 经处理后,表面有疏水效果,有效防止水印及水渍残留。
4. 不含任何有害物质的成分,符合RoHS标准。
5. 药水稳定,操作简易。
6. 适用于铜材镀银IC leadframe、镍钯金PPF、粗镍PPF、棕化后QFN leadframe。
UPC IC/SMD支架塑封促进剂 Ag 01P
UPC IC/SMD支架塑封促进剂Ag 01P应用于IC引线框架/SMD支架之表面处理技术的湿电子化学品。为IC引线框架/SMD支架的银层制程上,提升银层与塑封结合力,增加芯片与银层之间结合力,有效防止分层问题。
特性与优点
1. 提高MSL(Moisture Sensitivity Level)的可靠性能力。
2. 通过药水的湿制程表面处理技术,有助提升银层表面与塑胶 (树脂类)注塑之间的表层结合力,防止分层问题,提升热塑性和热固性。
3. IC Leadframe(引线框架),LED/SMD(发光二极管/贴片),在封装时,因树脂塑胶封装与框架(金属层)是两种不同的物质,使用Ag 01P,能提高封装的封密性,令两者的结合力进一步提升。
IC引线框架密着性促进助剂 PP08
IC引线框架密着性促进助剂PP08是一种通过表面处理技术工艺,令金属表面产生高度交联纳米涂层,增强金属表面与合成树脂(环氧树脂,硅等)之间的结合力。有效提升引线框架在封装时的结合力,达到更佳的封密性(MSL-1效果),不需要粗化、粗铜、粗镍的工艺。
特性与优点
1. 增强金属与合成树脂之间的结合力,提高密着性,不分层。
2. 增强集成电路中,引线框架在封装时的结合力,达至MSL-1的稳定效果。
3. 工艺不影响打线、上芯片及可焊性等功能。
4. 适用于A42、铜材、银层、PPF、钯、金的引线框架。
UPC AS 酸性脱银表面处理剂
UPC AS是酸性的脱银药液,产品能达到高速脱银而不伤害底材的效果,适合在引线框架的电镀生产线上。
功能性电子级纳米保护浓缩液 UPC Sipro SS6
UPC SiPro SS6应用于电子通讯,新能源汽车端子充电插件,铝腔体滤波器发射器,通讯航天、军工导电插头、螺丝胚等。
特性与优点
1. 适用于滚掛,卷对卷连续镀的工艺制程。
2. 不含铬及其他危害化学品,满足RoHS要求。
3. 不影响导电性及焊接性。
4. 铝合金电子通讯腔体最佳的后处理效果。
5. 新能源汽车充电件的功能性需求。
6. 稳定效果满足硫化钾(5%)25℃浸泡 5 分钟不变色。
UPC LF 电解清洗剂
电解清洗剂适用于引线框架(高密度QFN、DFN、QFP、SSOP类)的后处理工艺,是一种有效处理银电化学沉积工艺后,支架上所残留的物质。经处理后不会影响镀层表面功能性的特性(例如:打线,固晶上芯片,注塑等),防止后工序Wire-band跳线,断线的情况。
特性与优点
1. 属于碱性阴极电解清洁剂,可应用在卷对卷电镀或片对片电镀线上。
2. 可用于引线框封装EMC工艺之后,清洗银表面,以加强焊线能力。
3. 不含任何有害物质的成分,符合RoHS标准。
4. 不会影响银层功能性。
5. 药水稳定,操作简易。
Copyright 2023 江门市优彼思半导体材料有限公司 版权所有 粤ICP备19045006号