
UPC WT ABC 电子应用级电化学铜沉积层功能液
UPC WT ABC功能液是一种填平,快速出光并且优越走位均镀能力佳的电子化学品;用量较省,使用范围较广,操作维护简单,能稳定提高产品质量及制程生产速度的优良产品制程,更具竞争力,性价比极高。
特性与优点
1. 工艺操作简单,制程工作液容易控制,兼容性高,电流密度范围宽阔,高低电流密度区效果均匀,优良的均镀性。
2. 沉积层的填平度极佳,不产生针孔、白雾、麻点。内应力低,富延展性与镍层的结合力良好,出光速度快。
3. 药水稳定性高,具备耐高温特性,使用量也不会提高及分解,仍能造出清亮饱满,无麻点的光亮铜沉积层。镀液对杂质的容忍度非常高。
4. 可应用于各种不同类型的底材,如铜、铁、黄铜等支架素材。
5. 可应用于电子行业,如电子产品LED、SMD、电子元件等产品制程。
UPC CuR 198 IC Leadframe 粗结构功能性载体制程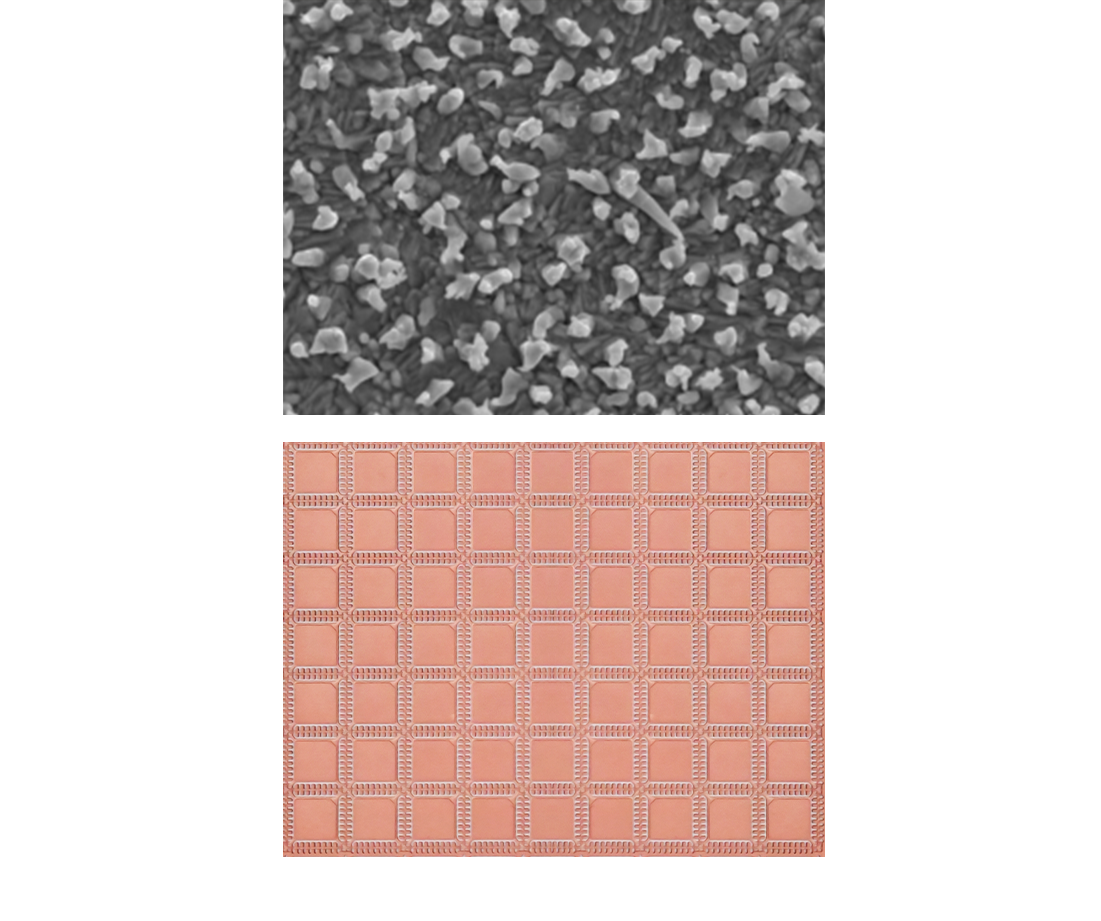
UPC CuR 198 电化学粗结构铜载体IC Leadframe制程,为业内提供电化学铜微结构工艺制程,引线框架铜底镀银产品中提高金属与封装树脂之间的密着性,满足MSL-1等级的需求,不分层(No Delamination)。沉积层可提供150-600nm粗糙度,车规级TO、SOIC需求。
特性与优点
1. 制程效果满足达到车载IC应用要求,达到MSL-1等级。
2. 提高电化学沉积铜粗微结构金属与封装树脂之间的密着性。
3. 适用于半导体元件及引线框架的工艺,能够提高封装密着性。
4. 特殊的凹凸状铜粗微沉积结构形态,增加结合力,不分层。
5. 低应力及良好延展性的结构层。
6. 不影响后工序焊锡湿润性的效果。
UPC LF_CuR_1033 IC Leadframe 电化学粗铜结构功能性载体制程
UPC LF_CuR_1033 电化学粗铜结构沉积层的IC Leadframe生产制程,为业内提供电化学粗铜微结构的工艺制程,使引线框架表面粗铜底再镀银产品中提高金属与封装树脂之间的密着性,满足MSL一级可靠性的需求,粗铜沉积层可提供150 - 450 nm Ra粗糙度,S-Ratio 1.2或以上,适用于车规级DFN、QFN、SOIC及功率半导体元件需求。
特性与优点
1. 工艺制程效果满足达到车载IC应用要求,达到MSL-1等级。
2. 电化学沉积铜粗微结构金属与封装树脂之间密着性提高的工艺。
3. 适用于半导体元件,引线框架的工艺,提高封装密着性。
4. 特殊的凹凸状铜粗微沉积结构形态,增加结合力,不分层。
5. 低应力及良好延展性的结构层。
6. 不影响后工序焊锡湿润性的效果。
UPC FAB Cu_Pillar 2018 CP 电子电化学铜工艺
UPC FAB Cu_Pillar 2018 CP设计用于先进封装电化学铜沉积层结构工艺,成功满足RDL patterns、ultra deep cupillar能力。
特性与优点
1. 制程容易控制,电化学铜沉积层的均匀度极佳。
2. 镀层不产生针孔,内应力低,富延展性,均匀性高。
3. 电流密度范围宽阔。
4. 可应用于各种不同类型的材料,WIW、WID芯片制程、陶瓷基板。
UPC Cu Ⅲ 铜表面技术工艺
UPC Cu Ⅲ 铜表面技术工艺是一种在各种 IC 基板/框架 Interposer 介质层上,EMC/LF结合力等,铜表面的功能特性。应用在 IC、先进封装材料上,能达到增加结合力。如果工艺应用于点镀银的框架(Flip chip bonding)上,UPC Cu Ⅲ 能有效控制在2.5 D/3 DIC封装、芯片 pillar bump 上的 solder cap(焊接平衡性)防止 Solder cap 溢出在铜的框架表面上(锡在铜面上滚动而不沾上),增加封装制程可靠性。
特性与优点
1. 优良的结合力(Mold compound 与 Leadframe)。
2. 均匀的功能性表面,满足封装需求。
3. 工艺使用条件稳定,范围宽。
4. 能满足FC bonding 框架应用需求。
5. 不影响不伤害银/金镀层的表面功能性。
Copyright 2023 江门市优彼思半导体材料有限公司 版权所有 粤ICP备19045006号