走进芯片的三维世界:2.5D/3D封装技术解析
在芯片产业的发展历程中,摩尔定律一直是推动技术进步的核心驱动力。然而,随着制程工艺不断接近物理极限,传统的二维平面集成方式面临着越来越多的挑战。2.5D/3D封装技术的出现,为芯片产业带来了新的发展方向,开启了芯片的三维时代。
一、什么是2.5D/3D封装?
2.5D封装和3D封装是两种不同的先进封装技术,它们都旨在提高芯片的集成度和性能,但实现方式有所不同。
2.5D封装:将多个芯片并排放置在硅中介层上,通过微凸块和硅中介层内部的金属线实现芯片之间的电气连接。硅中介层下方通过硅通孔(TSV)与封装基板相连,最终实现芯片与外部电路的连接。
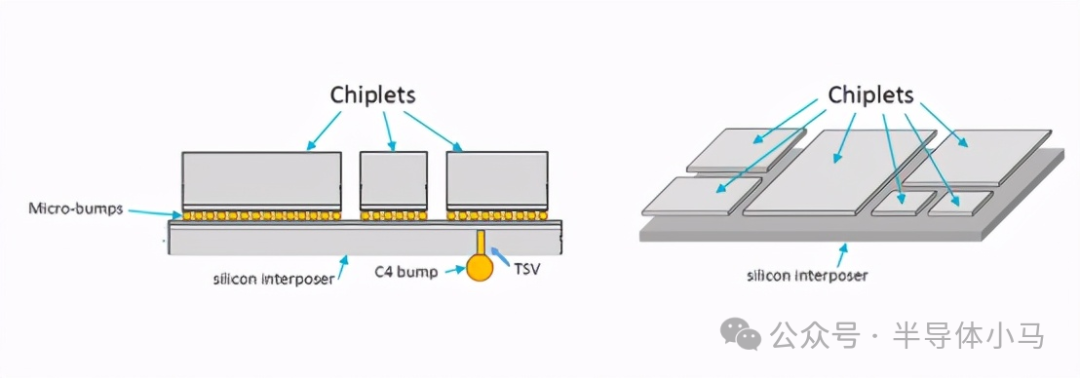
图 | 2.5D封装原理
3D封装:将多个芯片垂直堆叠在一起,通过硅通孔(TSV)直接实现芯片之间的电气连接。这种封装方式可以最大限度地减小芯片的占地面积,提高集成度。

图 | 3D封装技术
二、打破三大壁垒:先进封装的意义
突破存储墙:在传统的芯片设计中,处理器和存储器之间的数据传输需要通过长距离的总线,这导致了数据传输延迟和功耗增加。2.5D/3D封装技术通过将处理器和存储器紧密集成在一起,缩短了数据传输路径,提高了数据传输速度,有效突破了存储墙的限制。
突破面积墙:随着芯片制程工艺的不断进步,芯片的面积也在不断增大。然而,芯片面积的增大受到光刻机光罩尺寸的限制。2.5D/3D封装技术通过将多个芯片集成在一起,可以在不增大单个芯片面积的情况下,实现更高的集成度。
突破功能墙:2.5D/3D封装技术可以实现不同功能芯片的异质集成,将传感、存储、计算、通信等不同功能的元器件集成在一起,实现电、磁、热、力等多物理场的有效融合,从而突破功能墙的限制。
三、技术基石:关键封装技术解析
硅通孔(TSV)技术:硅通孔(TSV)是2.5D/3D封装技术的核心,它通过在硅片上钻孔并填充金属等导电材料,实现芯片之间的垂直互连。TSV技术可以大大缩短芯片之间的互连距离,提高数据传输速度。

图 | TSV硅通孔
重新布线层(RDL)技术:重新布线层(RDL)技术可以改变芯片线路接点的位置,使芯片能够适用于不同的封装形式。RDL技术可以增加芯片的I/O数量,提高芯片的灵活性和可扩展性。
混合键合(HB)技术:混合键合(HB)技术通过分子间作用力(范德华力)实现芯片之间的连接,具有更高的互联密度和可靠性。HB技术可以省略再布线层,降低设计难度,提高封装效率。
四、Chiplet:芯粒IP复用的创新
Chiplet技术是2.5D/3D封装技术的重要应用之一,它将大型单片芯片划分为多个小芯片(芯粒),这些小芯片可以使用不同的工艺节点制造,然后通过先进封装技术集成在一起。

图 | Chiplet示意图
Chiplet的优势:
· 接力摩尔定律:Chiplet技术可以在不继续缩小制程工艺的情况下,提高芯片的集成度和性能。
· 提高良率:小芯片的良率通常高于大型单片芯片,因此Chiplet技术可以提高芯片的整体良率。
· 降低成本:Chiplet技术可以将不同工艺节点的小芯片集成在一起,降低芯片的制造成本。
· 缩短设计周期:Chiplet技术可以实现芯粒IP的复用,缩短芯片的设计周期。
五、产业格局:从材料到设备的全面升级
封装材料:国产替代任重道远:先进封装技术的发展带动了封装材料的需求增长。目前,高端封装材料市场主要由日本企业占据主导地位,中国大陆企业在部分领域取得了一定的突破,但整体国产化率仍有待提高。
封装设备:前道设备需求加剧:先进封装技术需要在晶圆划片前融入封装工艺步骤,因此需要使用大量的前道制造设备。随着先进封装技术的不断发展,封装设备市场有望迎来快速增长。
市场规模:先进封装占比超50%:根据SEMI数据,2022年全球半导体封装材料市场规模为280亿美元,预计到2027年将达到298亿美元。先进封装市场占比已超过50%,成为封装市场的主流。
六、应用场景:从消费电子到人工智能
智能手机:在智能手机领域,2.5D/3D封装技术可以实现多芯片的集成,提高手机的性能和功能。例如,苹果的A系列芯片采用了先进封装技术,实现了处理器和存储器的紧密集成。
人工智能:在人工智能领域,2.5D/3D封装技术可以实现高带宽存储器(HBM)和处理器的紧密集成,提高人工智能计算的效率。例如,英伟达的H100 GPU采用了先进封装技术,实现了HBM3e存储器的集成。
智能驾驶:在智能驾驶领域,2.5D/3D封装技术可以实现传感器、处理器和存储器的集成,提高智能驾驶系统的性能和可靠性。

图 | 先进封装应用
七、未来趋势:向高密度封装时代迈进
封装间距持续缩小:未来,封装的各类间距将会进一步下降,Bump I/O间距将会缩小至50-40μm之间,重布层线宽间距将至2/2μm,高密度封装时代渐行渐近。
异构集成成为主流:异构集成将成为未来芯片封装的主流趋势,通过将不同工艺、不同功能的芯片集成在一起,可以实现更高的性能和更低的成本。
国产替代加速推进:随着中国大陆半导体产业的不断发展,先进封装领域的国产替代将加速推进。国内企业在封装材料、封装设备和封装技术等方面都取得了一定的突破,未来有望在全球市场中占据更大的份额。
八、结语
2.5D/3D封装技术是芯片产业从摩尔定律到超越摩尔定律的关键拐点,它为芯片产业的发展带来了新的机遇和挑战。随着技术的不断进步和应用场景的不断拓展,2.5D/3D封装技术将在未来的芯片产业中发挥越来越重要的作用。
来源:《半导体小马》
免责申明:文章版权归原作者所有,如您(单位或个人)认为内容有侵权嫌疑,敬请立即通知我们,我们将第一时间予以更改或删除。





